
p-n-переход (электронно-дырочный переход) - слой с пониженной электропроводностью, образующийся на границе полупроводниковых областей
с электронной (n-область) и дырочной (р-область) проводимостью.
Различают гомопереход, получающийся в результате изменяющегося в пространстве
легирования донорной и акцепторной примесями одного и того же полупроводника (напр.,
Si), и гетеропереход ,в котором р-область и n-область принадлежат
разл. полупроводникам. Термин "p-n-переход" как правило, применяют
к гомопереходам.
Обеднённый слой. Из-за большого градиента
концентрации электронов (п)и (обратного ему по знаку) градиента
концентрации дырок (р)в p-n-переходе происходит диффузионное
перетекание электронов из п-об-ласти в р-область и дырок
в обратном направлении. Его следствием является накопление избыточного
положит. заряда в n-области и отрицательного - в р-области
(рис. 1). При этом появляется электрич. поле, направленное из n-области
в р-область, действие которого на электроны и дырки (при термодинамич.
равновесии) компенсирует действие градиентов концентрации, т. е. диффузионные
потоки электронов и дырок уравновешиваются дрейфовыми потоками во внутреннем
электрич. поле Евн перехода. Поле Евнобусловливает
диффузионную разность потенциалов VД (аналог контактной
разности потенциалов), величина которой (для невырожденных носителей)
в р- и n-областях выражается ф-лой

Здесь е - заряд электрона, Т - темп-pa полупроводника, ni - концентрация электронов в собств. полупроводнике, пп и рр - концентрации электронов и дырок в п- и р-областях. Внутр. электрпч. поле сосредоточено в обеднённом (запорном) слое p-n-перехода, где концентрации носителей обоих типов меньше концентраций основных носителей в р- и n-областях вдали от перехода (п<пп, р<рр), а мин. уровень суммарной концентрации электронов и дырок достигает значения (п+ р)мин= 2ni. Т. к. в обеднённом слое, как правило, разность концентрации свободных носителей мала по сравнению с разностью концентраций ионизиров. доноров (Nд) и акцепторов (Na), границы этого слоя с квазинейтральными р- и n-областями wp и wnмогут быть найдены (после приближённого интегрирования Пуассона уравнения в одномерном случае) из ф-л

где e
- диэлектрпч. проницаемость полупроводника.
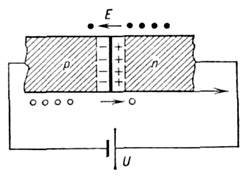
Рис. 1. Схематическое изображение р - n-перехода; чёрные кружки - электроны, светлые - дырки.
Т. к. Ферми уровень во всём полупроводнике при термодинамич. равновесии должен быть единым,
то в области перехода энергетич. зоны полупроводника изгибаются (рис. 2),
так что образуется потенциальный барьер, высота которого равна Vд.
во всём полупроводнике при термодинамич. равновесии должен быть единым,
то в области перехода энергетич. зоны полупроводника изгибаются (рис. 2),
так что образуется потенциальный барьер, высота которого равна Vд.
Внеш. напряжение U, приложенное
к p-n-переходу, в зависимости от знака уменьшает (прямое смещение,
плюсы соответствуют р-области) или увеличивает (обратное смещение)
напряжённость электрич. поля в обеднённом слое, сужая или расширяя его
при этом. Зависимость положения границ слоя wn, wp, от смещения U может быть найдена из ф-л (2),
где следует заменить VД
на VД - U (U > 0 при прямом смещении и U <
0 - при обратном). В случае резкого сильно асимметричного p-n-перехода
(Na NД) с т. н. металлургической границей (на которой
NД - Na =0) x0 = 0
и однородно легированной n-областью (Nд = const):
NД) с т. н. металлургической границей (на которой
NД - Na =0) x0 = 0
и однородно легированной n-областью (Nд = const):

В случае плавного p-n-перехода с постоянным градиентом разности концентрацией доноров и акцепторов (Nд - Na = ах, а = const):


Рис. 2. Зонная диаграмма (н) и концентрации
электронов и дырок (б) в области р - п-перехода; - дно зоны проводимости,
- дно зоны проводимости, - вершина валентной зоны;
- вершина валентной зоны; - уровень Ферми.
- уровень Ферми.
Определяемая толщиной обеднённого слоя w(U)= |wn(U) - wp(U)| зарядная ёмкость С3 p-n-переход уменьшается с ростом обратного смещения но закону С3 ~ (|U| + VД)-1/2 в случае ф-лы (3) (для резкого перехода) и Сз ~ (| U| + VД)1/3 - в случае ф-лы (4) (для плавного перехода). При увеличении прямого смещения зарядная ёмкость растёт. Измерение зависимости C3(U)позволяет исследовать изменение разности Nд(x) - Na(x) в p-n-переходе.
С включением внеш. напряжения U дрейфовые потоки перестают компенсировать
диффузионные потоки и через p-n-переход течёт электрич. ток. Т. к.
в глубине р-области ток переносится дырками, а в n-области
- электронами, то прохождение тока через p-n-переход - в прямом направлении
(U > 0) сопряжено с рекомбинацией электронов и дырок, прибывающих
к p-n-переходу из областей, где они являются основными носителями
заряда. При U < О ток обусловлен генерацией электронно-дырочных
пар в окрестности p-n-перехода, который разделяет их движение от p-n-перехода
в области, где они являются основными носителями.
При термодинамич. равновесии термич. генерация
носителей в каждой точке образца в точности компенсируется их рекомбинацией.
Но при прохождении тока этот баланс нарушается. Существует неск. механизмов
(каналов) избыточной генерации и рекомбинации, определяющих проводимость
p-n-перехода при прямом и обратном смещениях. а) Генерация и
рекомбинация носителей в р- и n-областях и диффузия носителей
к p-n-переходу или от него. В единице объёма n-полупроводника
в единицу времени рождается вследствие равновесной термич. генерации дырок, где рп - равновесная концентрация дырок в п-областп
дырок, где рп - равновесная концентрация дырок в п-областп
 а
а - их
время жизни относительно процесса рекомбинации. Все дырки, рождённые в
слое с толщиной Lр, прилегающем к p-n-переходу,
уходят в р-область, т. к. внутр. поле p-n-переход "втягивает"
туда все дырки, подошедшие к переходу в результате диффузии из п-области;
Lp - длина диффузии дырок в n-области за время их жизни:
- их
время жизни относительно процесса рекомбинации. Все дырки, рождённые в
слое с толщиной Lр, прилегающем к p-n-переходу,
уходят в р-область, т. к. внутр. поле p-n-переход "втягивает"
туда все дырки, подошедшие к переходу в результате диффузии из п-области;
Lp - длина диффузии дырок в n-области за время их жизни: Dp - коэф. диффузии дырок. Дырки, рождённые вне слоя Lp,
рекомбинируют прежде, чем процесс диффузии доставит их к p-n-переходу,
и не дают вклада в ток. Поэтому плотность тока дырок, уходящих из п-области
в р-область:
Dp - коэф. диффузии дырок. Дырки, рождённые вне слоя Lp,
рекомбинируют прежде, чем процесс диффузии доставит их к p-n-переходу,
и не дают вклада в ток. Поэтому плотность тока дырок, уходящих из п-области
в р-область:

Аналогично плотность тока электронов, термически рождённых в р-области и доставленных диффузионно к втягивающему их p-n-переходу

Здесь - их равновесная концентрация в р-области, Dn,
- их равновесная концентрация в р-области, Dn, Ln - коэф. диффузии, время жизни, длина диффузии в этой
области
Ln - коэф. диффузии, время жизни, длина диффузии в этой
области
Если бы токам jnsи jps
не противостояли бы обратные противотоки, то через p-n-переход
проходил бы ток насыщения плотностью js = jns
+ jps. Однако в отсутствие виеш. смещения токи неосновных
носителей jns и jps полностью компенсируются
токами основных носителей (электронов из n-области и дырок из р-области),
идущими в обратную сторону и равными, следовательно, также jns
и jрs. Основные носители - дырки, переходящие из р-области
в n-область, и электроны, идущие из n-области в р-область,
преодолевают на своём пути потенциальный барьер высотой Vд
и являются по своей природе термоэлектронной (термодырочной) эмиссией через
этот барьер. Поэтому понижение барьера на величину U при прямом
смещении приводит к увеличению каждого из этих токов в exp(eU/kT)раз
(см. Термоэлектронная эмиссия)и не вызывает изменения токов неосновных
носителей (для которых барьера нет). С учётом этого обстоятельства плотность
полного тока через p-n-переход можно выразить т. н. ф-лой Шокли (рис.
3):


Рис. 3. Вольт-амперная характеристика (ВАХ) v - п-перехода.
При U <0 и e|U|/kT 1
токами термоэмиссии основных носителей через повышенный обратным смещением
барьер (высотой Vд + |U|)можно пренебречь и считать,
что плотность обратного тока обусловлена только термогенерац. токами неосновных
носителей: j = - js (рис. 4, кривая 3). При U >
0 и eU/kT
1
токами термоэмиссии основных носителей через повышенный обратным смещением
барьер (высотой Vд + |U|)можно пренебречь и считать,
что плотность обратного тока обусловлена только термогенерац. токами неосновных
носителей: j = - js (рис. 4, кривая 3). При U >
0 и eU/kT 1,
наоборот, в ф-ле (7) можно сохранить только экспоненциальный член, описывающий
термоэмиссию носителей из областей, где они являются основными, в области,
где они становятся неосновными и где рекомбииируют за времена
1,
наоборот, в ф-ле (7) можно сохранить только экспоненциальный член, описывающий
термоэмиссию носителей из областей, где они являются основными, в области,
где они становятся неосновными и где рекомбииируют за времена и
и на расстояниях
Lp и Ln. Прямой ток, согласно (7), быстро растёт с ростом
U. При значит. смещениях этот рост ограничивается сопротивлением
р- и n-областей. Последнее уменьшается благодаря инжекции
неосновных носителей p-n-перехода. Из сравнения ф-л (5) и (6) видно,
что гл. вклад в ток насыщения обычно даёт слаболегированная сторона
p-n-перехода с более низкой концентрацией основных носителей.
на расстояниях
Lp и Ln. Прямой ток, согласно (7), быстро растёт с ростом
U. При значит. смещениях этот рост ограничивается сопротивлением
р- и n-областей. Последнее уменьшается благодаря инжекции
неосновных носителей p-n-перехода. Из сравнения ф-л (5) и (6) видно,
что гл. вклад в ток насыщения обычно даёт слаболегированная сторона
p-n-перехода с более низкой концентрацией основных носителей.

Рис. 4. Обратные токи р - п-перехода; 1 - тон термогенерации в квазинейтральных областях; 2 - тон термогенерации в обеднённом слое; 3 - ток туннельной генерации; 4 - полный ток в отсутствие фотогенерации; 5 - - фототок jф; 6 - полный ток с учётом фототока.
б) Генерация и рекомбинация в обеднённых
слоях (механизм Шокли - Са-Нойса). Рекомбииационно-генерац. ток, описываемый
ф-лой (7), не всегда доминирует. В широкозонных полупроводниках (с большой
запрещённой зоной )
при относительно низких теми-pax может преобладать термич. генерация и
рекомбинация в самом обеднённом слое, а не в слоях с толщинами Lп и Lр. Хотя в таком полупроводнике, как кремний, Ln и Lp обычно сильно превосходят ширину обеднённого
слоя w(U), но скорость генерации и рекомбинации там может
быть существенно выше, чем в квазинейтральных областях, из-за различия
в заполнении примесных уровней электронами, ответственными за рекомбинацию.
В этом случае при достаточно больших обратных смещениях (eU/kT
)
при относительно низких теми-pax может преобладать термич. генерация и
рекомбинация в самом обеднённом слое, а не в слоях с толщинами Lп и Lр. Хотя в таком полупроводнике, как кремний, Ln и Lp обычно сильно превосходят ширину обеднённого
слоя w(U), но скорость генерации и рекомбинации там может
быть существенно выше, чем в квазинейтральных областях, из-за различия
в заполнении примесных уровней электронами, ответственными за рекомбинацию.
В этом случае при достаточно больших обратных смещениях (eU/kT 1)
справедлива ф-ла
1)
справедлива ф-ла

где - время жизни неравновесных носителей в обеднённом слое, отличное в общем
случае от
- время жизни неравновесных носителей в обеднённом слое, отличное в общем
случае от и
и Ток jwможет
превышать js за счёт того, что пiпревышает
пр и рп. Ток jwне
насыщается с ростом обратного смещения, а растёт по мере расширения обеднённого
слоя [напр., в соответствии с ф-лами (3) и (4), рис. 4, кривая 2].
Ток jwможет
превышать js за счёт того, что пiпревышает
пр и рп. Ток jwне
насыщается с ростом обратного смещения, а растёт по мере расширения обеднённого
слоя [напр., в соответствии с ф-лами (3) и (4), рис. 4, кривая 2].
В прямом направлении ток, обусловленный рекомбинацией в обеднённом слое:

Здесь причём длина lЕ по порядку величины равна "сжатой" длине
диффузии носителей против внутр. поля Евн: l ~
kT/eE. Коэф. 2 в знаменателе показателя экспоненты связан с тем, что носители,
рекомбинирующие внутри обеднённого слоя, преодолевают не весь барьер, обусловленный
полем в нём, а только его часть, высота которой с приложением внеш. напряжения
U уменьшается на U/2. Из-за этого с ростом U ток по
ф-ле (9) растёт медленнее, чем ток по ф-ле (7), и даёт ему обогнать себя
при достаточно больших смещениях.
причём длина lЕ по порядку величины равна "сжатой" длине
диффузии носителей против внутр. поля Евн: l ~
kT/eE. Коэф. 2 в знаменателе показателя экспоненты связан с тем, что носители,
рекомбинирующие внутри обеднённого слоя, преодолевают не весь барьер, обусловленный
полем в нём, а только его часть, высота которой с приложением внеш. напряжения
U уменьшается на U/2. Из-за этого с ростом U ток по
ф-ле (9) растёт медленнее, чем ток по ф-ле (7), и даёт ему обогнать себя
при достаточно больших смещениях.
в) Межзонное (зинеровское) туннелированне.
Ток электронов через запрещённую зону полупроводника отсутствует только
при классич. описании движения электронов проводимости и дырок в электрич.
поле. Оно становится недостаточным с ростом напряжённости поля. Из-за туннелирования
электронов сквозь запрещённую зону (эффект Зинера) тормозящийся в электрич.
поле электрон проводимости, отразившись от дна зоны проводимости имеет вероятность (тем большую, чем круче наклонены зоны) перейти в валентную
зону (рис. 5, а). При одинаковых эффективных массах электрона
и дырки вероятность туннелирования в однородном электрич. поле близка к
вероятности туннелирования сквозь треугольный барьер, высота которого равна
ширине запрещённой зоны
имеет вероятность (тем большую, чем круче наклонены зоны) перейти в валентную
зону (рис. 5, а). При одинаковых эффективных массах электрона
и дырки вероятность туннелирования в однородном электрич. поле близка к
вероятности туннелирования сквозь треугольный барьер, высота которого равна
ширине запрещённой зоны а толщина
а толщина тем меньше, чем больше напряжённость поля Е.
тем меньше, чем больше напряжённость поля Е.
Для реализации туннельного перехода необходимо
наличие в валентной зоне дырок. Поэтому туннельный переход является туннельной
рекомбинацией электрона из зоны проводимости с дыркой из валентной зоны.
Такой рекомбинац. процесс не связан ни с передачей энергии колебаниям решётки
(т. е. с её нагревом), ни с излучением света: энергия передаётся источнику
электрич. поля. Обратный процесс - рождение электронно-дырочной пары за
счёт энергии электрич. поля (туннельная или зинеровская генерация) - в
условиях термодинамич. равновесия уравновешивает рекомбинацию. Оба эти
процесса в p-n-переходе при U = 0 имеют место лишь в случае,
когда электронный газ в n-области и дырочный газ в р-области
вырождены (рис. 5,б). Прямое смещение ведёт к преобладанию туннельной
рекомбинации, а обратное смещение - к туннельной генерации. Туннельная
составляющая тока такого перехода доминирует над прочими только тогда,
когда он предельно резкий. Резкий p-n-переход с вырожденным газом
носителей по обе стороны лежит в основе туннельного диода, имеющего
на прямой ветви вдоль вольт-амперной характеристики падающий участок N-типа
(ВАХ, рис. 5, в).
В случае невырожденных п- и р-областей
туннельный ток может преобладать только при достаточно больших обратных
смещениях и связан только с туннельной генерацией электронно-дырочных пар.
Ввиду экспоненциальной зависимости туннельного тока от напряжённости электрич.
поля вклад в него даёт лишь окрестность точки макс. поля. По мере роста
обратного напряжения туннельный ток, незаметный на фоне термогенерационного
при низких напряжениях, стремительно нарастает и становится преобладающим
(рис. 4, кривая 3).
В широкозонных полупроводниках наряду
с термогенерационными и туннельными токами наблюдают их различные комбинации.
С одной стороны, имеет место сочетание туннельных (горизонтальных) переходов
между зонами и уровнями локальных примесных центров с термогенерационными
(вертикальными) переходами (рис. 5, г). С др. стороны, возможно туннелирова-ние
с поглощением неск. фононов (рис. 5, д).

Рис. 5. Туннельные явления в р - n-переходе; а - межзонное туннелированис; б - зонная диаграмма туннельного диода; в - прямая ветвь ВАХ туннельного диода (1 - полная плотность тока, 2 - нетуннельная составляющая); г - комбинация термического (1)и туннельного (2)переходов с участием примесного уровня; д - возможные варианты генерации: 1 - термическая (многофононная); 2 - туннельная (бесфононная); 3 - туннелирование с поглощением фононов.
г) Ударная ионизация. Электроны проводимости
с энергией, превышающей её порог, могут порождать электронно-дырочные пары,
истратив на это почти всю свою энергию в зоне. Такую же возможность имеют
и дырки с надпороговой энергией. Пороги ударной ионизации для электрона
и дырки различны (однако во мн. случаях они слегка превышают )..
Рождение электронно-дырочной пары носителями, ускоренными до необходимых
энергий в электрич. поле обратно смещённого перехода, ответственно за лавинное
размножение носителей в p-n-переходе и за его лавинный пробой.
)..
Рождение электронно-дырочной пары носителями, ускоренными до необходимых
энергий в электрич. поле обратно смещённого перехода, ответственно за лавинное
размножение носителей в p-n-переходе и за его лавинный пробой.
Обычно процессы ударной ионизации описывают
с помощью коэф. и
и определяемых
как ср. числа электронно-дырочных пар, генерируемых одним электроном и
одной дыркой на единичном пути их дрейфа в электрич. поле Е. Вшироких
обеднённых слоях
определяемых
как ср. числа электронно-дырочных пар, генерируемых одним электроном и
одной дыркой на единичном пути их дрейфа в электрич. поле Е. Вшироких
обеднённых слоях (х) - локальные функции электрич. поля в точке х:
(х) - локальные функции электрич. поля в точке х:

Здесь т = 1, 2; коэф. bn,р
не зависят от Е, а Сп,рзависят слабо. Из-за сильной зависимости от Е в ударную ионизацию, как и в туннельную генерацию, вносит вклад
только близкая окрестность точки макс. электрич. поля в обеднённом слое.
от Е в ударную ионизацию, как и в туннельную генерацию, вносит вклад
только близкая окрестность точки макс. электрич. поля в обеднённом слое.
Из-за ударной ионизации обратный ток p-n-перехода, обусловленный термической или туннельной генерацией, а также
фото генерацией или инжекцией носителей надлежит умножить на коэф.
M(U):
J1(U) = j(U) M(U). При =
= =
= (приближённо имеющем место во мн. полупроводниках при больших значениях
|Е|)величина M(U)перестаёт зависеть от места, где произошла
первичная генерация, и равна
(приближённо имеющем место во мн. полупроводниках при больших значениях
|Е|)величина M(U)перестаёт зависеть от места, где произошла
первичная генерация, и равна

(направление оси х выбрано из р-области в п-область).

Это определяет напряжение Uпр
лавинного пробоя p-n-перехода: стационарный режим с обратным напряжением
на p-n-переходе U > Uпр невозможен.
Для лавинного пробоя важна ударная ионизация обоими типами носителей. Если
в размножении участвуют, напр., одни только электроны, то напряжение Uпр оо(бесклнечность).
оо(бесклнечность).
Лавинный пробой, как правило, имеет микроплазменный
характер: ток течёт не по всей площади p-n-перехода, а локализован в
отд. точках (микроплазмах), выявляемых по яркому свечению. С ростом тока
пробоя число микроплазм растёт вплоть до однородного покрытия ими всей
площади.
Если хотя бы одна сторона p-n-перехода
легирована слабо или же p-n-переход имеет плавную структуру, лавинный
пробой наступает при напряжении, недостаточном для проявления заметной
туннельной генерации. В резких переходах с сильным легированием обеих сторон
туннельная генерация начинает доминировать до наступления лавинного пробоя,
так что ему предшествует на обратной ветви ВАХ участок быстрого туннельного
нарастания тока (рис. 4).
д) Фотогеперация, сторонняя инжекция.
Током p-n-перехода можно управлять с помощью фотогенерации неравновесных
носителей в его окрестности. Ток jф, обусловленный фотогенерацией
(фототок), в отсутствие лавинного размножения аддитивно складывается с
др. составляющими тока, а при наличии лавинного размножения - с составляющими
первичного тока. При наличии фототока (кривая 5, рис. 4) ВАХ не проходит
через точку j = 0, U = 0, возникает участок, на котором знак
j не совпадает со знаком U (кривая 6, рис. 4). В этом режиме
p-n-переход выступает в качестве фотоэлемента ,преобразующего
энергию излучения в электрич. энергию (см. также Солнечная батарея ).Кроме режима фотоэлемента используется режим фотодиода, отвечающий
обратной ветвп ВАХ.
Другой способ управления током p-n-перехода - инжекция неосновных
носителей в одну из образующих переход областей полупроводника с помощью
другого p-n-перехода или иного инжектирующего контакта. Этот способ
управления током p-n-перехода - коллектора путём инжекции p-n-перехода
- эмиттером лежит в основе работы транзисторов.
Ток p-n-перехода можно также изменять разогревом носителей эл--магн. излучением СВЧ-или
ИК-диапазона.
Сплавные переходы получают, нанося на полупроводниковую кристаллическую
подложку "навеску" легкоплавкого металлического сплава, в состав
которого входит необходимое легирующее вещество. При нагреве образуется область
жидкого расплава, состав которого определяется совместным плавлением навески
и подложки. При остывании формируется рекристаллизац. область полупроводника,
обогащённая легирующими атомами. Если тип легирования этой области отличен
от типа легирования подложки, то образуется резкий
p-n-переход, причём
его металлургич. граница х0совпадает с границей рекристаллизац.
области. В сплавных переходах на этой поверхности разность изменяется скачком
(резкий
р - n-переход).
При вытягивании из расплава формирование
перехода происходит в процессе роста полупроводникового слитка путём дозированного
изменения состава легирующих примесей в расплаве. Диффузионные переходы
получают диффузией легирующих примесей из источников в газообразной, жидкой
и твёрдой фазах. Имплантированные переходы образуются при ионной имплантации легирующих примесей.
Эпитаксиальные переходы получают методом
эпитак-сиального выращивания или наращивания, в т. ч. методом молекулярно-лучевой
эпитаксии, позволяющим пространственно наиболее тонко (с разрешающей способностью
до 1 нм) регулировать закон изменения NД(x) - Na(x). Часто
применяются комбиниров. способы: после вплавления, имплантации или эпитаксиального
выращивания производится диффузионная доводка структуры.
При получении p-n-перехода регулируется
не только легирование р- и n-областей, но и структура всего
переходного слоя; в частности, получается необходимый градиент
а = d(NД
- Na)/dx в точке металлургич. перехода х =
х0. В большинстве случаев применяются асимметричные p+-n-переходы
или p-n+-переход, в которых легирование одной из
областей (+) намного сильнее другой.
p-n-переход обладает нелинейной ВАХ с большим коэф. выпрямления, на чём
основано действие выпрямительных (полупроводниковых) диодов. За счёт
изменения толщины обеднённого слоя с изменением напряжения U он
имеет управляемую нелинейную ёмкость (см. Варикап ).Включённый в прямом направлении, он инжектирует носители
из одной своей области в другую. Инжектиров. носители могут управлять током
другого p-n-перехода, рекомбинировать с излучением света, превращая
p-n-переход в электролюминесцентный источник излучения (см. Светоизлцчающий
диод), инерционно задерживаться в области инжекции при быстрых переключениях
напряжения на p-n-переходе. Ток p-n-перехода управляется
светом или др. ионизирующими излучениями (см. Полупроводниковый детектор).
Свойства p-n-перехода обусловливают
их применение в разл. приборах: выпрямительные, детекторные, смесительные
диоды (см. Диоды твердотельные; )биполярные и униполярные транзисторы;
туннельные диоды; лавинно-пролётные диоды (СВЧ-генераторы); фотодиоды,
лавинные фотодиоды, фототранзисторы; тиристоры, фототиристоры; фотоэлементы,
солнечные батареи; светодиоды, инжекц. лазеры; детекторы частиц и др. p-n-переходы вытесняются Шоттки барьерами ,изотипными гетеропереходами,
планарно-легированными барьерами.

3. С. Грибников
|
|