

Полупроводниковый лазер - лазер на
основе полупроводниковой активной среды. В отличие от лазеров др. типов, в
полупроводниковых лазерах используются квантовые переходы между разрешёнными энергетич. зонами, а не
дискретными уровнями энергии (см. Полупроводники ).
Лазерный эффект в полупроводниковых лазерах связан в осн. с межзонной люминесценцией (излучат. рекомбинацией
созданных внеш. воздействием избыточных электронов и дырок; рис. 1). Поэтому
длину волны l лазерного излучения можно выразить через ширину запрещённой
зоны 

где h - постоянная Планка, с -
скорость света.
Полупроводниковые лазеры перекрывают спектральный диапазон от 0,3
мкм до
0,3
мкм до  45
мкм (рис. 2).
45
мкм (рис. 2).
В полупроводниковой активной среде может достигаться очень большой
показатель оптич. усиления (до  ),
благодаря чему размеры полупроводниковых лазеров исключительно малы, напр. длина резонатора может
составлять неск. мкм, типично - 200-300 мкм. Помимо компактности, особенностями
полупроводниковых лазеров являются малая инерционность
),
благодаря чему размеры полупроводниковых лазеров исключительно малы, напр. длина резонатора может
составлять неск. мкм, типично - 200-300 мкм. Помимо компактности, особенностями
полупроводниковых лазеров являются малая инерционность  высокий кпд
высокий кпд возможность плавной спектральной перестройки, большой выбор веществ для генерации
в широком спектральном диапазоне.
возможность плавной спектральной перестройки, большой выбор веществ для генерации
в широком спектральном диапазоне.
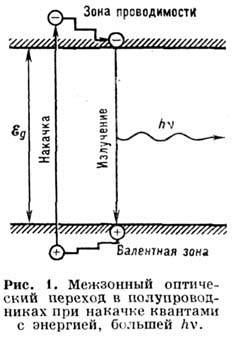
К достоинствам полупроводниковых лазеров следует также отнести совместимость
полупроводниковых лазеров с полупроводниковыми приборами др. типов и возможность монолитной интеграции,
возможность электронного управления режимом генерации и параметрами излучения
- длиной волны, степенью когерентности, числом спектральных мод и т. п., возможность
ВЧ-модуляции излучения путём модуляции тока накачки, низковольтность (<1-3
В) электропитания, а также наибольшую среди лазеров др. типов долговечность
(до  ч).
ч).
Полупроводниковый лазер включает в себя активный элемент из полупроводникового
монокристалла, чаще всего в форме бруска ("чипа"). Собственно активная
область элемента обычно составляет лишь его малую часть, и её объём, напр, в
современном, т. н. полосковом, инжекционном лазере, оказывается в пределах
 Оптический резонатор полупроводникового лазера образован либо торцевыми
зеркальными гранями активного элемента (изготовляемого обычно путём раскалывания
пластин по плоскостям спайности кристалла), либо внеш. отражателями и сложными
устройствами с периодич. структурами обратной связи (брэгговскими отражателями
и структурами распределённой обратной связи).
Оптический резонатор полупроводникового лазера образован либо торцевыми
зеркальными гранями активного элемента (изготовляемого обычно путём раскалывания
пластин по плоскостям спайности кристалла), либо внеш. отражателями и сложными
устройствами с периодич. структурами обратной связи (брэгговскими отражателями
и структурами распределённой обратной связи).
Др. способами накачки служат электрич. пробой
в сильном поле (напр., в т. н. стримерных лазерах), освещение
(полупроводниковые лазеры с оптической накачкой) и бомбардировка быстрыми электронами
(полупроводниковые лазеры с электронно-лучевой или электронной накачкой).
Пполупроводниковые лазеры с накачкой электрич. пробоем содержит активный
элемент в форме чипа-резонатора с контактами для подведения высоковольтного
напряжения. В стримерном полупроводниковом лазере используется пробой при стримерном разряде в
однородном полупроводниковом образце высокого сопротивления. Напряжение в этом
полупроводниковом лазере подводится в виде коротких импульсов, а излучающее пятно быстро перемещается
вслед за головкой (стримером) электрич. разряда.
При использовании оптич. или электронно-лучевой
накачки активная область располагается в приповерхностном слое полупроводникового
образца, и толщина этой области зависит от глубины проникновения энергии накачки.
В зависимости от взаимного расположения пучка накачки и лазерного луча используют
как продольный, так и поперечный вариант геометрии накачки.
Полупроводниковый лазер с электронно-лучевой
накачкой помимо активного элемента (мишени) включает в себя электронную пушку.
Особенностью лазеров с такой накачкой является возможность быстрого изменения
конфигурации накачки, напр. сканирования со скоростями, обеспечивающими воспроизведение
телевиз. изображения (лазерное проекц. телевидение).
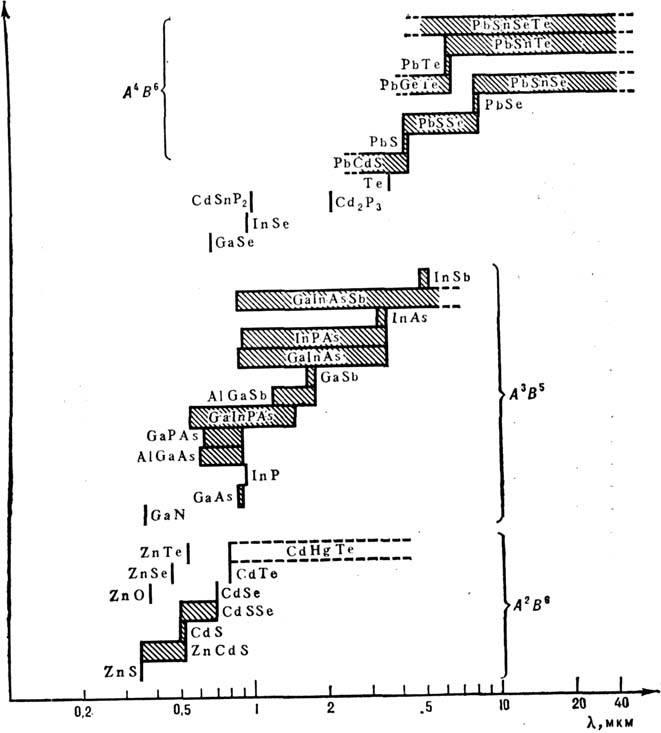
Рис. 2. Полупроводники, используемые в полупроводниковых
лазерах, и спектральные диапазоны излучения.
Физический механизм. Рабочие уровни в полупроводниковых лазерах обычно
принадлежат энергетич. зонам, т. е. областям сплошного спектра энергетич. состояний,
а активными частицами лазерной среды являются свободные носители заряда. Накачка
обеспечивает поступление избыточных электронов в зону проводимости и избыточных
дырок в валентную зону (напр., оптич. накачка порождает избыточные пары носителей
- электронов и дырок - за счёт межзонного поглощения; см. в ст. Полупроводники). Время свободного пробега носителя обычно мало (10-13 - 10-12
с) вследствие быстрых процессов внут-ризонной релаксации носителей (в частности,
электрон-электронных столкновений, рассеяния на фононах и примесях и т. и.).
В результате неравновесные носители могут "термализоваться", т.
е. перейти на более низкие энергетич. уровни в пределах своей зоны, распределившись
по энергии  в соответствии с функцией распределения Ферми для электронов и дырок (см. Ферми - Дирака распределение):
в соответствии с функцией распределения Ферми для электронов и дырок (см. Ферми - Дирака распределение):


Здесь Т - абс. температура, т. н. квазиуровни Ферми .Образно говоря, электроны "скатываются"
ко "дну" зоны проводимости
т. н. квазиуровни Ферми .Образно говоря, электроны "скатываются"
ко "дну" зоны проводимости а дырки "всплывают" к "потолку" валентной зоны
а дырки "всплывают" к "потолку" валентной зоны  раньше,
чем рекомбинируют между собой. Время жизни избыточных носителей, ограниченное
рекомбинацией, само по себе довольно мало
раньше,
чем рекомбинируют между собой. Время жизни избыточных носителей, ограниченное
рекомбинацией, само по себе довольно мало
 однако оно существенно превышает время свободного пробега и время, необходимое
для термализации носителей. Это справедливо и в том случае, когда используется
накачка активной среды быстрыми электронами, исходная энергия к-рых составляет
однако оно существенно превышает время свободного пробега и время, необходимое
для термализации носителей. Это справедливо и в том случае, когда используется
накачка активной среды быстрыми электронами, исходная энергия к-рых составляет
 эВ. Электроны
накачки порождают лавину вторичных неравновесных электронов и дырок, термализующихся
к краям своих зон. Время релаксации электронов большой энергии также очень мало
из-за возможности расхода энергии на ионизацию (порождение вторичных пар) и
на генерацию ВЧ-фоеонов.
эВ. Электроны
накачки порождают лавину вторичных неравновесных электронов и дырок, термализующихся
к краям своих зон. Время релаксации электронов большой энергии также очень мало
из-за возможности расхода энергии на ионизацию (порождение вторичных пар) и
на генерацию ВЧ-фоеонов.
Состояние возбуждённой полупроводниковой среды,
при к-ром имеется избыток концентрации носителей, распределённых, однако, в
осн. в соответствии с фермиевскими функциями  называют квазиравновесным, подчёркивая тем самым энергетич. равновесность внутри
каждой зоны при отсутствии равновесия между зонами.
называют квазиравновесным, подчёркивая тем самым энергетич. равновесность внутри
каждой зоны при отсутствии равновесия между зонами.
Мерой отклонения от равновесия концентрации носителей
при квазиравновесии служит разность 
 излучат. переходы преобладают над переходами с поглощением, если вероятность
заполнения электронами верхних рабочих уровней превышает вероятность заполнения
ими ниж. уровней. Это условие сводится к следующему неравенству:
излучат. переходы преобладают над переходами с поглощением, если вероятность
заполнения электронами верхних рабочих уровней превышает вероятность заполнения
ими ниж. уровней. Это условие сводится к следующему неравенству:

где  -
энергия ниж. состояния (в валентной зоне),
-
энергия ниж. состояния (в валентной зоне),  - энергия верх, состояния (в зоне проводимости); величина
- энергия верх, состояния (в зоне проводимости); величина  представляет собой вероятность заполнения соответствующего состояния электроном.
С учётом (2) для квазиравновеспя условие (3) может быть выражено в виде
представляет собой вероятность заполнения соответствующего состояния электроном.
С учётом (2) для квазиравновеспя условие (3) может быть выражено в виде

и поскольку для межзонного перехода то одноврем. выполняется условие
то одноврем. выполняется условие


Рис. 3. Полосковый инжекционный лазер: а - общий
вид в сборке; б - схема; в - сечение вблизи активной области (АО).
Неравенство (5) является условием инверсии для
межзонных переходов. Инверсия населённостей может быть получена и для переходов
между зоной и примесным уровнем или примесными зонами в легиров. полупроводниках,
и даже между дискретными уровнями примесного центра (напр.,
полупроводниковые лазеры на внутрицентровом переходе в InP, легированном Fe,
работающий на длине волны 2,7 мкм при 2 К).
Созданы также излучатели когерентного дальнего ИК-излучения, работающие при
низкой температуре в режиме коротких импульсов
на внутривенных переходах в скрещённых электрич. и магн. полях.
Состояние инверсии достигается благодаря действию
интенсивной накачки и в случае межзонных переходов выполняется прежде всего
для рабочих уровней, находящихся на самых краях обеих зон (в сильноле-гиров.
полупроводниках - для уровней в "хвостах" зон, протягивающихся в
номинально запрещённую зону). Это объясняет справедливость соотношения (1) для
большинства лазеров, т. е. объясняет связь энергии фотона лазерного излучения
с шириной запрещённой зоны излучающего полупроводника. Все факторы,
оказывающие действие на ширину запрещённой
зоны полупроводника (темп-pa, давление, магн. поле), влияют на длину волны лазерного
излучения полупроводникового лазера и одноврем. на показатель преломления среды. Это позволяет осуществлять
перестройку длины волны лазерного излучения, напр. для спектроскопич. целей.
С др. стороны, для получения лазерного излучения на фиксиров. длине волны необходимо
предпринимать меры для её стабилизации, поддерживая на пост. уровне температуру,
ток накачки и т. п.
запрещённой
зоны полупроводника (темп-pa, давление, магн. поле), влияют на длину волны лазерного
излучения полупроводникового лазера и одноврем. на показатель преломления среды. Это позволяет осуществлять
перестройку длины волны лазерного излучения, напр. для спектроскопич. целей.
С др. стороны, для получения лазерного излучения на фиксиров. длине волны необходимо
предпринимать меры для её стабилизации, поддерживая на пост. уровне температуру,
ток накачки и т. п.
Условие инверсии может быть выполнено для фотонов
в нек-рой спектральной полосе (рис. 4). Для получения эффекта лазерной генерации
оптич. усиление должно компенсировать все потери потока фотонов в прело-лах
лазерного резонатора, образуемого обычно собственно активной средой и зеркальными
плоскостями.
Рис. 4. Спектральный контур полосы оптического усиления в полупроводниковом лазере.

Такая компенсация достигается прежде всего вблизи
максимума усиления, если не применена дополнит. спектральная селекция, смещающая
рабочую частоту лазера. На пороге генерации должны быть выполнены два условия
- компенсация энергетич. потерь за счёт оптич. усиления и наличие положит. обратной
связи за счёт частичного (или полного) отражения оптич. потока от зеркал обратно
в активную среду. Если R - коэф. отражения и К - коэф.
усиления на длине активной среды между зеркалами, то условие генерации имеет
вид

(при включении накачки для накопления фотонов
в резонаторе необходимо выполнить условие КR > 1 в стационарном режиме,
если пренебречь вкладом спонтанного излучения  Для естеств. плоской поверхности полупроводникового кристалла, напр. GaAs,
Для естеств. плоской поверхности полупроводникового кристалла, напр. GaAs,  0,32
(если внеш. среда - воздух или вакуум). Следовательно, для возникновения генерации
оказывается достаточным
0,32
(если внеш. среда - воздух или вакуум). Следовательно, для возникновения генерации
оказывается достаточным  3,
что легко можно получить на сравнительно малой длине активной среды (100 - 300
мкм), если учесть, что показатель усиления в полупроводниковой среде легко достигает
значений
3,
что легко можно получить на сравнительно малой длине активной среды (100 - 300
мкм), если учесть, что показатель усиления в полупроводниковой среде легко достигает
значений 
Рис. 5. Энергетические диаграммы прямозонного
(а) и непрямозонного (б) полупроводников.

В полупроводниковых лазерах применяются так называемые прямозонные
полупроводники (рис. 5, а), в к-рых термализирующиеся носители
обоих знаков приобретают примерно одинаковый квазиимпульс ,собираясь
в соответствующих экстремумах своих зон и затем излучательно рекомбинируя
с выполнением закона сохранения квазиимпульса (импульс фотона составляет относительно
малую величину). В непрямозонных полупроводниках (рис. 5, 6)для рекомбинации
носителей требуется участие др. частиц или квазичастиц (напр., фононов, обладающих
соответствующим квазиимпульсом), что существенно снижает вероятность излучат.
перехода. В результате излучат. переходы не могут конкурировать с безызлучательными.
Для непрямозонных полупроводников (к ним относятся, в частности, Si, Ge, SiC,
GaP и др.) характерна слабая межзонная люминесценция, в них не развивается усиление,
достаточное для возникновения генерации на этих переходах. Попытки создания
эфф. лазеров на непрямозонных полупроводниках остались безуспешными. Прямозонные
полупроводники, используемые в
полупроводниковых лазерах (рис. 1), относятся в осн. к трём группам
соединений:
 (первые две используются в инжекц. полупроводниковые лазеры). Кроме бинарных соединений, имеются
многочисл. ряды изоморфных твёрдых растворов (на рис. 2 даны их сокращённые
ф-лы: напр. GalnPAs означает где x и у - мольные доли соединений Ga
(первые две используются в инжекц. полупроводниковые лазеры). Кроме бинарных соединений, имеются
многочисл. ряды изоморфных твёрдых растворов (на рис. 2 даны их сокращённые
ф-лы: напр. GalnPAs означает где x и у - мольные доли соединений Ga и
As, соответственно, составляющих многокомпонентную, в данном случае четырёхкомпонентную,
смесь).
и
As, соответственно, составляющих многокомпонентную, в данном случае четырёхкомпонентную,
смесь).
Среди лазерных материалов выделяются соединения
и составы, входящие в т. н. изопериодические пары, т. е. пары кристаллов, различающиеся
по хим. составу, ширине запрещённой зоны и др. физ свойствам, но имеющие одинаковый
период кристаллич решётки Такие материалы пригодны для образования бездефектных
гетеропереходов путём наращивания одного материала на другом эпитаксиаль-ными
методами (см. Эпитаксия ).Совершенные гетеропереходы необходимы для формирования
лазерных гетероструктур, широко используемых в современных
полупроводниковых лазерах (наз. также гетеролазерами).
В изопериодич. паре более узкозонный компонент
служит в качестве активного вещества и, следовательно, должен быть прямозонным
материалом. Более широкозонный компонент выполняет роль эмиттерных слоев. Подбор
изопериодич. материалов среди бинарных соединений весьма ограничен. Лучшей парой
являются соединения GaAs (прямозонное 1,5эВ)
и AlAs (непрямозонное,
1,5эВ)
и AlAs (непрямозонное,  2,1 эВ), у к-рых периоды решётки различаются на 0,14%. В твёрдых растворах бинарных
соединений период решётки плавно зависит от состава; возможности подбора в них
изопериодич. пар расширяются. Примером могут служить пара InP (
2,1 эВ), у к-рых периоды решётки различаются на 0,14%. В твёрдых растворах бинарных
соединений период решётки плавно зависит от состава; возможности подбора в них
изопериодич. пар расширяются. Примером могут служить пара InP ( =
1,35 эВ) и
=
1,35 эВ) и  =0,74
эВ), используемая в гетеролазере на длине
волны 1,67 мкм. В четверных и др. многокомпонентных твёрдых растворах существуют
непрерывные ряды изопериодич. материалов: напр., пара
=0,74
эВ), используемая в гетеролазере на длине
волны 1,67 мкм. В четверных и др. многокомпонентных твёрдых растворах существуют
непрерывные ряды изопериодич. материалов: напр., пара 
 перекрывает
диапазон длин волн 1,0-1,67 мкм, если-между c и у соблюдается
"изопериодическое" условие В
перекрывает
диапазон длин волн 1,0-1,67 мкм, если-между c и у соблюдается
"изопериодическое" условие В лазерных
гетероструктурах активная область обычно представляет собой тонкий или сверхтонкий
(< 100 нм) слой (иногда - неск. таких слоев с прослойками между ними), заключённый
между широкозонными эмиттерными слоями (т. н. двойная гетерострук-тура). Активный
слой обычно обладает свойствами ди-электрич. волновода, к-рый удерживает поток
излучения, распространяющийся вдоль него, и уменьшает дифракц. оптич. потери.
Активный слой образует собой потенц. яму для избыточных носителей одного или
обоих знаков, и в случае особо малой его толщины (< 30 нм) в нём проявляется
волновая природа электронов - квантование энергетич. уровней в яме оказывает
влияние на спектральную форму полосы усиления. Такие полупроводниковые
лазеры называются квантоворазмерными
или лазерами с "квантовыми ямами". Уменьшение активного объёма позволяет
понизить мощность накачки, необходимую для получения режима генерации. В наиб.
миниатюрных лазерах пороговый ток генерации составляет ок. 1 мА при комнатной
температуре, а для получения оптич. мощности 1 мВт достаточен ток накачки 5-10 мА.
Распространённым вариантом пленарной лазерной гетероструктуры является двойная
гетеро-структура с трёхслойным волноводом (рис. 6), в к-рой собственно
активный слой снабжён тонкими волновод-ными прослойками. На основе такой модифициров.
гетероструктуры достигнуты наиб. высокие характеристика ннжекц. лазера. В т.
н. заращённых или заглублённых полосковых гетероструктурах активный волновод
представляет собой полоску, ограниченную гетеропереходами со всех боковых сторон.
лазерных
гетероструктурах активная область обычно представляет собой тонкий или сверхтонкий
(< 100 нм) слой (иногда - неск. таких слоев с прослойками между ними), заключённый
между широкозонными эмиттерными слоями (т. н. двойная гетерострук-тура). Активный
слой обычно обладает свойствами ди-электрич. волновода, к-рый удерживает поток
излучения, распространяющийся вдоль него, и уменьшает дифракц. оптич. потери.
Активный слой образует собой потенц. яму для избыточных носителей одного или
обоих знаков, и в случае особо малой его толщины (< 30 нм) в нём проявляется
волновая природа электронов - квантование энергетич. уровней в яме оказывает
влияние на спектральную форму полосы усиления. Такие полупроводниковые
лазеры называются квантоворазмерными
или лазерами с "квантовыми ямами". Уменьшение активного объёма позволяет
понизить мощность накачки, необходимую для получения режима генерации. В наиб.
миниатюрных лазерах пороговый ток генерации составляет ок. 1 мА при комнатной
температуре, а для получения оптич. мощности 1 мВт достаточен ток накачки 5-10 мА.
Распространённым вариантом пленарной лазерной гетероструктуры является двойная
гетеро-структура с трёхслойным волноводом (рис. 6), в к-рой собственно
активный слой снабжён тонкими волновод-ными прослойками. На основе такой модифициров.
гетероструктуры достигнуты наиб. высокие характеристика ннжекц. лазера. В т.
н. заращённых или заглублённых полосковых гетероструктурах активный волновод
представляет собой полоску, ограниченную гетеропереходами со всех боковых сторон.
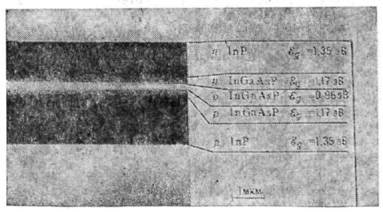
Рис. 6. Двусторонняя лазерная гетероструктура
на основе InGaAsP/InP с трёхслойным волноводом (l = 1,3 мкм).
В инжекц. лазерах удаётся использовать только
те лазерные материалы, в к-рых можно получить p - n-переход или p - n-гетеропереход, а также возможно обеспечить протекание тока достаточно
высокой плотности  К ним не относятся, в частности, прямозонные соединения типа
К ним не относятся, в частности, прямозонные соединения типа и
ряд др. полупроводников (Те, GaSe и др.). Ко всем материалам
для полупроводниковых лазеров, однако, применимы бесконтактные способы накачки - оптическая и электронно-лучевая.
и
ряд др. полупроводников (Те, GaSe и др.). Ко всем материалам
для полупроводниковых лазеров, однако, применимы бесконтактные способы накачки - оптическая и электронно-лучевая.
 при ма-
при ма- лой толщине активного слоя. В некоторых образцах полупроводниковых лазеров
кпд (коэф. преобразования элект-рич. энергии в энергию лазерного излучения)
достигает 30-40%. Типичная мощность непрерывного излучения полоскового
полупроводникового лазера - ок. 10 мВт, хотя наилучшие ресурсные характеристики (напр., безотказная наработка
> ч) соответствуют
мощности 1-3 мВт.
ч) соответствуют
мощности 1-3 мВт.
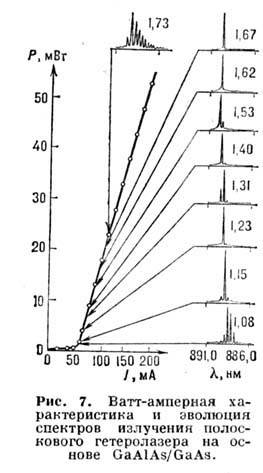
Многоэлементные излучатели - фазированные
лазерные монолитные "линейки" - обеспечивают
мощность лазерного излучения на уровне 5-15 Вт в зависимости от размеров излучателя
и числа полосковых элементов. В импульсном режиме мощность излучения ограничивается
оптич. прочностью материала (критич. интенсивность излучения в GaAs составляет
2-3  при длительности
импульса
при длительности
импульса  с).
Пиковая мощность инжекц. лазера с широким
контактом достигает 20-50 Вт; в лазерах с большим рабочим объёмом, накачиваемых
с помощью электронного пучка пли излучения др. лазера, мощность излучения в
импульсном режиме может достигать
с).
Пиковая мощность инжекц. лазера с широким
контактом достигает 20-50 Вт; в лазерах с большим рабочим объёмом, накачиваемых
с помощью электронного пучка пли излучения др. лазера, мощность излучения в
импульсном режиме может достигать Вт.
Вт.
Модовой состав излучения существенно зависит
от конструкции и размеров резонатора полупроводникового лазера, а также от
величины мощности излучения.
Полупроводниковый лазер испускает узкую спектральную линию, к-рая сужается с увеличением мощности
излучения, если не появляются пульсации и многомодовые эффекты. Сужение линии
ограничивается фазовыми флуктуациями, обусловленными спонтанным излучением.
Эволюция спектра излучения с ростом мощности в инжекц. лазере показана на рис.
7. В од-ночастотном режиме наблюдают сужение спектральной линии до Гц;
мин. значение ширины линии в полупроводниковых лазерах со стабилизацией
одночастотного режима с помощью селективного внеш. резонатора составляет величину
Гц;
мин. значение ширины линии в полупроводниковых лазерах со стабилизацией
одночастотного режима с помощью селективного внеш. резонатора составляет величину 0,5
кГц. В полупроводниковых лазерах путём модуляции накачки удаётся получить модулиров. излучение,
напр. в форме синусоидальных пульсаций с частотой, достигающей в нек-рых случаях
10-20 ГГц, или в форме УК-импульсов субпикосекундной длительности
0,5
кГц. В полупроводниковых лазерах путём модуляции накачки удаётся получить модулиров. излучение,
напр. в форме синусоидальных пульсаций с частотой, достигающей в нек-рых случаях
10-20 ГГц, или в форме УК-импульсов субпикосекундной длительности Осуществлена передача информации с помощью полупроводникового лазера со
скоростью 2-8 Гбит/с.
Осуществлена передача информации с помощью полупроводникового лазера со
скоростью 2-8 Гбит/с.
Применение полупроводниковых лазеров находят в бытовых и техн. устройствах
записи и воспроизведения информации (т. н. оптич. игла в проигрывателях на компакт-дисках,
видеодисках, в голографич. системах памяти), в лазерных принтерах, волоконно-оптич.
системах связи, системах накачки твердотельных лазеров, в автоматике, телеметрич.
датчиках, науч. исследованиях, в спектроскопии, спектральных датчиках, оптич.
дальномерах, высотомерах, в проекц. лазерном телевидении, оптич. "сторожах",
имитаторах стрельбы, индикаторах и т. д.
В заруб. странах годовое потребление полупроводниковых лазеров составляет  экземпляров, гл. обр. гетерлазеров на
основе GaAlAs/GaAs и InGaAsP/InP.
экземпляров, гл. обр. гетерлазеров на
основе GaAlAs/GaAs и InGaAsP/InP.

П. Г. Елисеев
|
|